




The as-cut silicon wafer SPL (Photoluminescence) testing equipment developed by Shichuang Intelligence is a professional device that conducts silicon wafer quality inspection based on the photoluminescence principle of silicon materials.
This equipment leverages the intrinsic excitation luminescence characteristics of silicon: when silicon atoms are excited, electrons transition from the valence band to the conduction band, and then emit fluorescence when transitioning back from the conduction band to the valence band.
The PL intensity is negatively correlated with the defect density and the concentration of recombination centers. Therefore, the quality of silicon wafers can be evaluated by detecting PL signals.
The as-cut silicon wafer PL testing technology can be widely applied in the early stages of photovoltaic product manufacturing, including silicon ingots, as-cut silicon wafers and textured wafers. It enables quality inspection during the early process steps before and after the diffusion of solar cells, achieving the dual goals of product quality control and manufacturing cost reduction.
(一)硅片生產質量控制:在硅片制造環節,原硅片PL檢測設備可應用于硅片分選機、制絨上料機等關鍵工序,對硅片進行在線或離線檢測,確保進入后續工序的硅片質量符合標準,從源頭把控產品質量。
(二)硅棒質量分析與分檔:通過對單晶硅棒進行切割取樣(約3mm厚晶圓),運用PL檢測技術分析厚硅晶的質量,有效去除廢料、協助硅棒分檔。可檢測黑邊、黑心、隱裂等不合格缺陷,指導硅棒切割工藝優化。
(三)制絨、擴散工序前檢測:利用PL檢測的高靈敏度特點,可應用于制絨片、擴散片、刻蝕片等低少子壽命的過程片檢測,在電池制造早期階段發現質量問題,避免后續工序的資源浪費。
(四)高校、實驗室研究測試:在光伏材料和電池技術研發中,PL檢測設備是性能分析與工藝優化的核心測試工具,可用于分析材料本征特性、評估工藝參數對硅片質量的影響。
可檢測擴散前的硅片、硅塊的PL信息
兼容單晶、類單晶、多晶硅片
可檢測晶硅的位錯、絨絲、晶界等缺陷
可集成于硅片分選機、制絨上料機,達到控制產品質量、節約制造成本的目的
可檢出外觀和隱裂模組不能檢出的晶象缺陷,包括:發黑、位錯、同心圓、黑角等缺陷。可根據灰度和缺陷比例計算PL值,PL值越低表示缺陷越嚴重。同心圓檢測:能夠清晰檢測硅片的同心圓缺陷,準確測量PL平均灰度(PL值)。可與外部生產線集成,輸出控制信號,實現自動化質量分級。同心圓指數越低代表樣本質量越好,反之則代表黑環情況越嚴重。
運用PL檢測技術對單晶硅棒進行切割分析,以有效去除廢料、協助硅棒分檔。
?從硅棒的一端切一片約3mm的厚晶圓,然后使用分析功能測量該樣本
?根據測量結果值檢查厚晶圓上是否有常見的不合格缺陷,如黑邊、黑心和隱裂等
?如果該厚晶圓不合格,再向里切一片約3mm的單晶厚晶圓,并再次進行質量檢測,重復直到合格為止
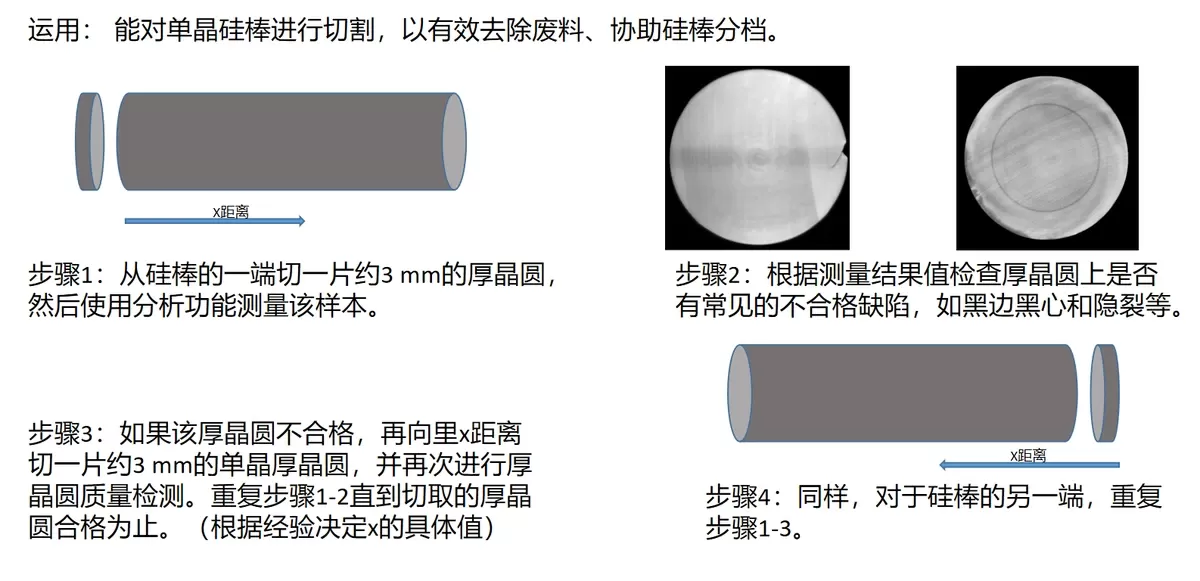
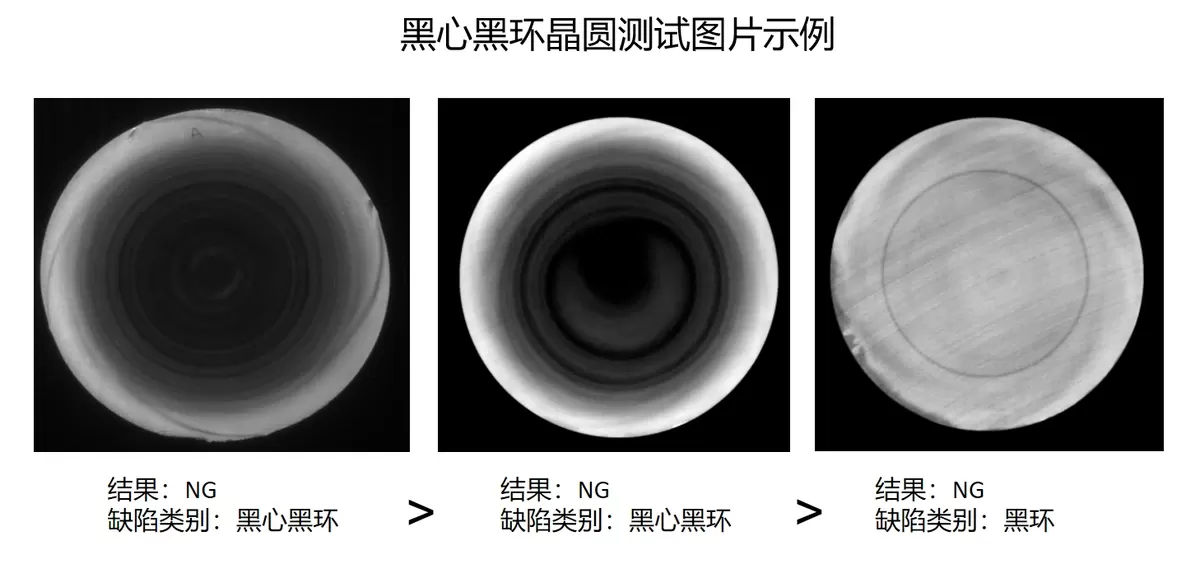
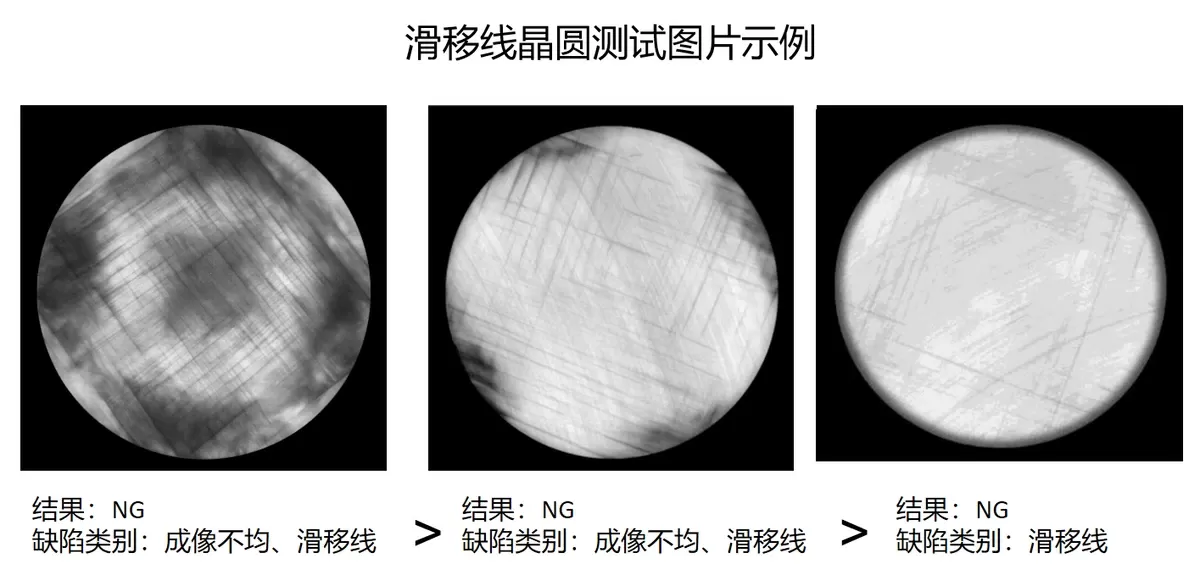
原硅片PL檢測利用了硅的本征激發發光特性,無需電接觸即可進行檢測。硅原子受激后,電子從價帶躍遷到導帶,再從導帶躍遷回價帶后發出熒光,PL強度負相關于缺陷密度及復合中心濃度,能夠真實反映材料的本征質量。
利用SPL高靈敏度的特點,可用于制絨片、擴散片、刻蝕片等低少子壽命的過程片檢測。能夠在電池制造早期階段發現質量問題,避免后續工序的資源浪費。
兼容單晶、類單晶、多晶硅片檢測
可檢測硅碇、原硅片、制絨片等多種形態
用于156mm×156mm至210mm×210mm規格硅片(半片、整片均兼容)
可檢測位錯、絨絲、晶界、隱裂等晶體缺陷
可識別發黑、黑斑、黑角、黑心、黑環等質量缺陷
能夠清晰檢測同心圓缺陷,評估PL平均灰度
可檢出外觀和隱裂模組不能檢出的晶象缺陷
可根據灰度和缺陷比例計算PL值
提供黑邊黑心指數、不均勻指數、同心圓指數等多維參數
可測量平均PL值、黑角面積、隱裂條數等量化指標
支持樣品測試結果統計分析
| 某硅片樣品測試結果分析 | |
|---|---|
 平均PL值:N型中>N型頭 |  不均勻性指數:N型平均大于P型 |
 樣品中未有黑邊黑角 |  同心圓指數:P型>N型平均值:N頭>N中,P尾>P中>P頭 |
多組N頭樣品測試結果 | |
 |  |
 |  |
 |  |
| 參數名稱 | 技術指標 |
|---|---|
| 型號 | SC-SPL |
| 相機規格 | 成像:NIR增強型InGaAs相機 分辨率:1K 線掃 曝光時間:10微秒~10秒 可響應范圍:900nm~1700nm(短波紅外 SWIR 波段) 最大行頻:40kHz |
| 紅外像素 | 1024×1 像素 |
| 鏡頭規格 | 高清廣角鏡頭,焦距(16mm/25mm/45mm多規格選配),視場角≥80°,可選配長焦鏡頭實現局部放大檢測 |
| 光源規格 | 半導體激光,主波長980±5nm |
| 光斑均勻性 | ≥90%(有效檢測區域內) |
| 曝光周期 | 20us~100000us(根據檢測對象響應時間自定義設置,最小步長1ms) |
| 檢測波長范圍 | 900nm~1300nm |
| 兼容尺寸規格 | 156mm*156mm~210mm210mm(半片,整片均兼容) |
| 檢測對象 | 晶棒切片、晶硅電池原料(拉晶、切片、原硅片、制絨) |
| 可檢測缺陷類型 | 位錯、絨絲、晶界、欒晶、發黑、同心圓、黑角等 |
| 載物臺尺寸 | 適配自動化軌道(按需定制) |
| 控制方式 | 自研上位軟件全自動化控制 |
| 檢測精度 | 可檢測出裂紋寬度大于50μm |
| 成像精度 | ≥0.2mm/pixel |
| 對焦模式 | 手動對焦 |
| 硬件支架 | 鋁合金型、鋁合金、金屬鈑金等 |
| 檢測時間 | 0.5s~2s(根據自動化機臺運行速度判斷) |
| 對焦距離 | 400-650mm |
| 測試平臺 | windows平臺,標配AI檢測軟件 |
| 功率 | 500-1000W |
| 電源特性保護 | 逆電流保護,過載保護,漏電保護,靜電保護,過熱保護 |
| 運算設備 | 工控計算機 |
| 環境溫度 | 溫度15-50℃,相對濕度30%-70%(無凝結) |
| 設備重量 | 約20kg(以實物為準) |
| 外形尺寸 | 400×350×800mm(長×寬×高,以實物為準) |
| 供電 | 單相AC220V±10%,50HZ±1HZ |
| 缺陷類型 | SPL成像 | 成像分析 |
|---|---|---|
| 原硅片同心圓 |  | 本次原硅片 PL 檢測顯示,樣品存在原硅片同心圓缺陷,呈現特征性環狀同心紋理形貌。該缺陷系晶體生長階段徑向溫度梯度不均、拉晶速度波動,致晶格沿徑向形成周期性缺陷分布所致,會破壞后續工序均勻性、降低電池性能一致性,需優化晶體生長徑向參數 |
| 晶界 |  | 本次制絨后硅片 PL 檢測顯示,樣品存在晶界缺陷,形貌呈現斑駁網狀的分界紋理:因不同晶粒的晶格取向差異,晶界區域晶格排列不連續,致 PL 信號不均形成該特征。晶界會成為載流子復合中心,降低載流子壽命,需優化晶體生長的晶粒管控或制絨工藝均勻性。 |
| 同心圓 |  | 本次制絨后硅片 PL 檢測(平均 PL 值:989.8;同心圓:2.172)顯示,樣品存在制絨后同心圓缺陷,呈現特征性環狀同心圓形貌。該缺陷系制絨工序中藥液徑向分布不均、硅片轉速波動,導致絨面刻蝕程度徑向差異所致,會破壞絨面均勻性,影響后續工藝匹配性及載流子傳輸,需優化制絨工序的藥液分布與轉速參數。 |
| 膜前片 |  | 本次膜前片 PL 檢測顯示,硅片存在塊狀黑斑、黑點缺陷:形貌為局部塊狀暗區及散在點狀暗斑,系原硅片基底雜質聚集、前道工序表面污染或物理損傷所致。該缺陷會干擾后續鍍膜均勻性,阻礙載流子傳輸,需強化前道硅片清潔及基底質量管控。 |
| 黑心黑環 |  | 本次硅片SPL 檢測顯示,硅片存在黑心黑環缺陷:形貌呈現環狀分層黑帶(黑環)與環狀明暗差異(黑心),系擴散工序溫度場徑向不均、反應氣體分布失衡,或原硅片徑向基底缺陷在擴散后顯現所致。該缺陷會破壞載流子分布均勻性,降低電池片光電轉換效率,需優化擴散工藝的徑向參數管控。 |
| 劃傷卡點印 |  | 本次硅片SPL 檢測顯示,硅片存在劃傷、卡點印缺陷:劃傷呈線性痕跡,卡點印為點狀 / 印狀瑕疵,系前道硅片搬運、裝夾時的物理接觸或異物卡點所致。這類缺陷會干擾擴散均勻性、阻礙載流子傳輸,需優化前道工序的操作及異物管控 |
| 黑心黑環 |  | 本次晶圓切片 PL 檢測顯示,樣品存在黑心黑環缺陷:形貌表現為晶圓中心區域發黑,且外圍伴隨環狀黑帶分布。該缺陷多因晶體生長階段中心區域雜質富集、徑向缺陷聚集,或加工時中心應力集中所致,會破壞載流子分布均勻性,降低電池片性能穩定性,需針對性優化晶體生長及加工的中心區域管控措施。 |
| 晶棒同心圓 |  | 本次晶圓切片 PL 檢測顯示,樣品存在晶圓同心圓缺陷,呈現特征性環狀同心圓形貌。該缺陷系晶體生長徑向溫度梯度波動、或切片工序徑向應力不均,致晶格沿徑向周期性錯排形成,會影響電池片性能一致性,需優化相關工序的徑向參數控制。 |
| 應力滑移線 |  | 本次硅棒切片 PL 檢測顯示,樣品存在顯著的應力滑移線缺陷,表現為特征性交叉條紋形貌。該缺陷由切片裝夾、切割等工序的機械應力作用引發,造成硅晶體原子面滑移、晶格錯排,會降低載流子壽命,影響后續光伏電池轉換效率,需優化切片應力控制參數。 |
配套設備推薦:晶硅/鈣鈦礦PL/EL一體機、光伏電池檢測
檢測出硅片中各種肉眼不可見缺陷
自動預測硅片的效率參考值
自動統計各缺陷與良品數量及比例,
產能大于6000片/小時
無接觸式檢測,不對硅片二次損傷
提前篩選出問題片,節約制造成本
contact
Be the first to know about our new product launches, latest blog posts and more. Nanjing Vision Potential Intelligent Technology Co.,Ltd.Established based on the Nanjing Xiangning Artificial Intelligence Research Institute, we have brought together a number of outstanding industry...
Nanjing Vision Potential Intelligent Technology Co.,Ltd.Established based on the Nanjing Xiangning Artificial Intelligence Research Institute, we have brought together a number of outstanding industry... Any question or request?
Click below, we’ll be happy to assist. contact